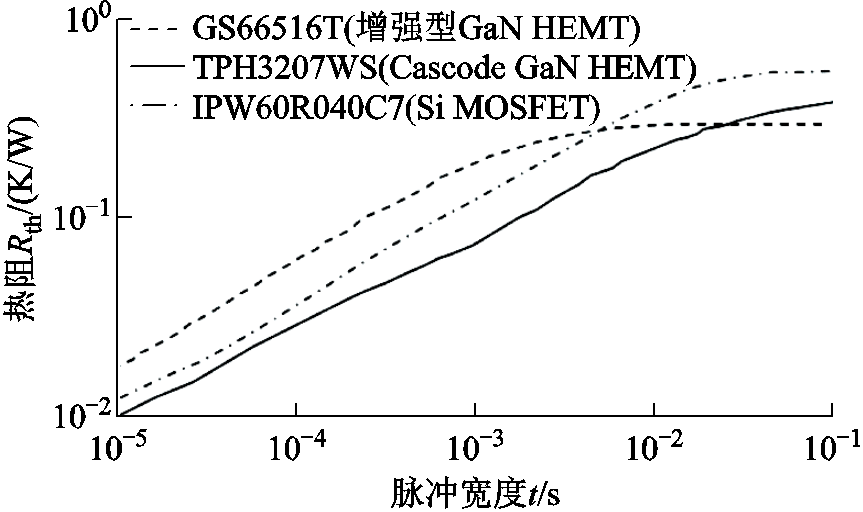
图1 三种常用器件的单脉冲热阻曲线
Fig.1 A single pulse thermal resistance curves for three commonly used devices
摘要 该文针对基于共源共栅氮化镓高电子迁移率晶体管(Cascode GaN HEMT)的直流固态功率控制器(SSPC)在开通过程中的振荡问题,利用Spice模型与Q3D软件提取Cascode结构内部寄生参数,结合SSPC实际工作情况和Cascode结构对开通和关断过程进行分析,在Saber软件中对SSPC开通过程进行仿真分析。仿真结果表明,振荡产生的主要原因是,在SSPC开通过程中,Cascode GaN HEMT长时间工作在饱和区,容易受到外界干扰产生振荡,且内部存在正反馈环路。针对该问题,该文提出并联RC吸收电路和增大门级驱动电阻的方案,实验结果表明,所提出的方案可以有效抑制振荡。
关键词:共源共栅氮化镓高电子迁移率晶体管 振荡 固态功率控制器 正反馈
随着多电/全电飞机的发展,飞机配电系统由常规配电、遥控配电逐步发展为固态配电[1-2]。固态配电通过固态功率控制器(Solid State Power Controller,SSPC)实现飞机上电负载的智能控制,极大地提高了飞机配电系统的智能性与可靠性[3]。
传统的SSPC多由硅(Si)功率器件构成,但是Si材料在高压下导通电阻Rds(on)较大,所以在大负载电流下其导通压降大、发热严重。在一定的导通压降要求下,Si器件需要并联的数目多、散热要求高、功率密度低。氮化镓(GaN)器件具有耐高温、导通电阻低、抗辐照等特点,且GaN材料具备较高的禁带宽度,对空间高能粒子流辐射有较高的抵抗能力,因此具有较好的应用前景[4]。当前常闭型商用GaN器件主要分为以下两种:增强型氮化镓高电子迁移率晶体管(Gallium Nitride High Electron Mobility Transistor, GaN HEMT)和共源共栅(Cascode)GaN HEMT。增强型GaN HEMT的阈值电压VTH较低,易误触发,且完全开通电压与栅极最高耐压接近,在受干扰时容易产生栅极过电压使器件损坏 [5-7]。图1给出了三种常用器件的单脉冲热阻曲线,高压增强型GaN HEMT采用嵌入式封装,瞬态热阻大,不利于冲击情况下的安全性;共源共栅(Cascode) GaN HEMT[7-9]的门级和漏源级耐压高,多采用TO-220及TO-247封装,瞬态热阻小,承受瞬态功率冲击能力强。例如,270V/10A固态功率控制器的后端负载短路时,短路保护时间100μs,过程中单管功率冲击为1 350W[10]。GS66516T(增强型GaN HEMT)温升为82.12℃;IPW60R040C7(Si MOSFET)温升为49.95℃;TPH3207WS(Cascode GaN HEMT)温升为38.45℃。综上将TPH3207WS应用于SSPC中可以进一步提升其性能。
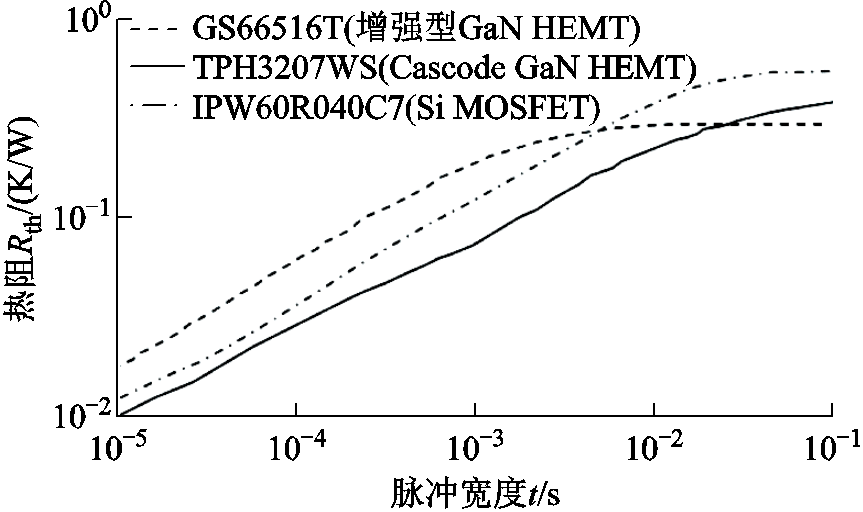
图1 三种常用器件的单脉冲热阻曲线
Fig.1 A single pulse thermal resistance curves for three commonly used devices
但是在实际应用中,Cascode GaN HEMT容易产生振荡[11-13],目前国内外针对Cascode GaN HEMT的振荡现象的研究主要集中于短路[14]及开关速度快(纳秒级)的情况下发生的振荡,文献[11]分析了大电流下关断时,Cascode GaN HEMT产生振荡并造成误开通的现象,并指出原因在于Cascode结构中Si MOSFET(金属-氧化物-半导体场效应管)与GaN HEMT间的电容在关断过程中大小发生变化,从而从功率端抽取额外的能量,但是在SSPC开通过程中,该变化过程相对于快开关缓慢得多,且在该过程中功率管始终要保持开通,所以该文献中的情况无法解释SSPC在开通过程中产生振荡的原因。文献[12-13]分析短路情况,但是其分析全部为快开关情况,驱动电压上升速度相比于SSPC应用环境快了一个数量级,且其振荡形式不同,文献[13]并未对此现象进行分析且未给出振荡抑制方案,在文献[12]中虽有提到解决方案,但均为修改功率管内部寄生参数以及引脚寄生电感大小,对解决SSPC工程应用问题的指导意义不大。
针对SSPC振荡的研究较少,文献[15]对SSPC短路关断的振荡现象进行了分析,指出了振荡原因为负载电流变化率过快,但是在文献[15]中的振荡是逐步衰减的且仅存在于短路关断过程中,与本文中实验现象不同,所以该文献指出的振荡原因不适用于本文。
因此,本文针对SSPC在开通过程中产生的振荡现象,结合Cascode结构对开通过程进行分析,并建立Saber仿真模型分析振荡产生的根本原因为Cascode结构在Si MOSFET和GaN HEMT均处在饱和状态时易受到干扰,且Cascode内部存在正反馈环路。针对振荡产生原因,本文提出了并联RC吸收电路和增大门级驱动电阻的方案,并通过实验验证所提方案的可行性。
为了抑制开通过程中的电流冲击,SSPC采用“慢开通,慢关断”控制策略,其核心为控制电压变化率恒定[10, 16],控制框图如图2所示。

图2 “慢开通,慢关断”控制框图
Fig.2 Control block diagram of "slow on, slow off"
该控制策略通过控制负载电压变化率恒定来抑制开通容性负载时的电流冲击,以及关断感性负载时的电压应力。开通关断时序如下:
t1~t2:t1时刻,上位机发出开通指令,开通关断控制指令(Command, CMD)置高,VGS开始上升,该阶段功率管始终保持关断状态。
t2~t3:t2时刻,VGS上升至开启电压Vth,功率管开始导通,功率管两端电压VDS线性下降,负载两端电压Vload线性上升。
t3~t4:t3时刻,功率管两端电压VDS下降为零,负载电压电流上升至额定值。
t5~t6:t5时刻,上位机发出关断指令,CMD置低。功率管栅源电压VGS下降。该阶段功率管的输出特性曲线仍处于可变电阻区,功率管保持饱和导通的状态,负载电压仍保持额定电压。
t6~t7:t6时刻,功率管两端电压VDS开始上升,负载电压电流开始下降,功率管开始关断。
t7~t8:t7时刻,功率管的栅源电压VGS下降至开启电压。此时功率管两端的电压已经上升至电源电压VDC,负载电压和电流下降为零。功率管栅源电容继续放电,栅源电压VGS继续下降至零。
“慢开通,慢关断”控制策略开通过程中功率管上的功率损耗可以表示为
 (1)
(1)
式中,Pon为开通过程中功率管平均功率;Ton为开通时间;VDC为母线电压;iSSPC(t)为负载电流,对于不同类型负载,iSSPC(t)的表达式是不同的。负载分为线性负载(包括阻性负载、容性负载和感性负载)和非线性负载(包括电机负载、开关电源变换器负载等)。对于非线性负载,当负载为电机负载时,如果电机直接挂在直流电源上,起动时将产生较大的冲击电流,可等效为阻容性负载;如果电机由变频器驱动,变频器前端通常并有大容量滤波储能电容,建压过程中存在很大的冲击电流,可等效为较大的纯容性负载。当负载为开关电源变换器负载时,由于输入端存在滤波电容,亦可等效成较大的容性负载。下面对于不同负载类型进行分析,阻性、纯容性、阻容性、感性负载对应的电流公式分别为
 (2)
(2)
 (3)
(3)
 (4)
(4)
 (5)
(5)
式中,Rload、Cload和Lload分别为负载电阻、电容和电感。代入式(1)即可求解出开通过程中的损耗,阻性负载开通损耗为
 (6)
(6)
可知整个开通过程中的效率为66.7%,但开通过程仅占整个SSPC工作过程的极小部分,SSPC的主要损耗为稳态导通功耗,样机额定电压、电流为270V、10A,功率管导通电阻为35mΩ,检测电阻为5mΩ,控制端功耗2W,故稳态导通效率约为99.8%。
在开通关断实验中,母线电压为70V、负载为27Ω电阻性负载。基于“慢开通,慢关断”开通阻性负载时的波形如图3所示。由实验波形可以看出,Cascode GaN HEMT在开通初期触发振荡,同时SSPC输出电压Vload以及功率管漏源极电压VDS也开始振荡,在振荡期间,振荡幅度呈先放大再迅速衰减的趋势,并在负载电压40V左右恢复正常。
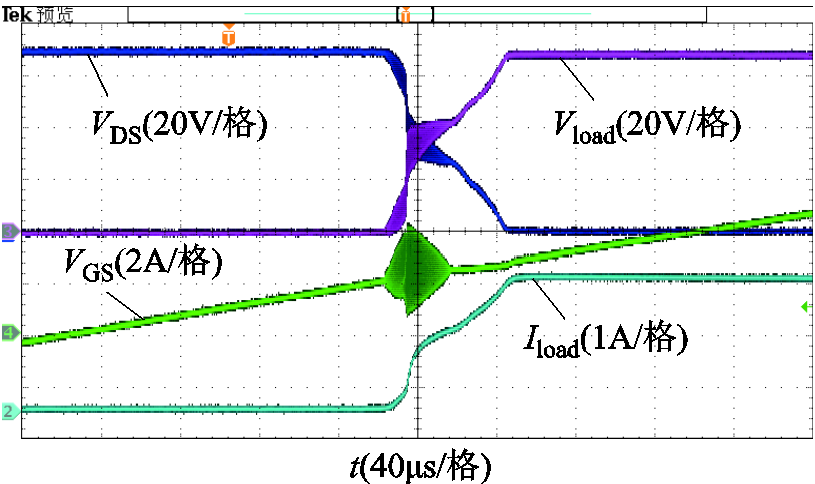
图3 阻性负载开通振荡
Fig. 3 Resistive load turn-on oscillation
从实验波形中可以看出,SSPC开通后开始振荡,振荡呈发散形式,并在负载电压达到40V左右时振荡熄灭。所以需要将控制策略结合器件自身结构进行分析。
下面结合“慢开通,慢关断”控制策略针对Cascode GaN HEMT的开通过程进行分析。图4为Cascode GaN HEMT内部结构,其中,CGS_M、CGD_M、CDS_M分别为Si MOSFET栅源极、栅漏极、漏源极电容,CGS_H、CGD_H、CDS_H分别为GaN HEMT栅源极、栅漏极、漏源极电容。Cascode GAN HEMT开通过程如图5所示。图中vGS_H、vTH_H分别为GaN HEMT功率管门极驱动电压和阈值电压;vGS_M、vTH_ M分别为Si MOSFET门极驱动电压和阈值电压。
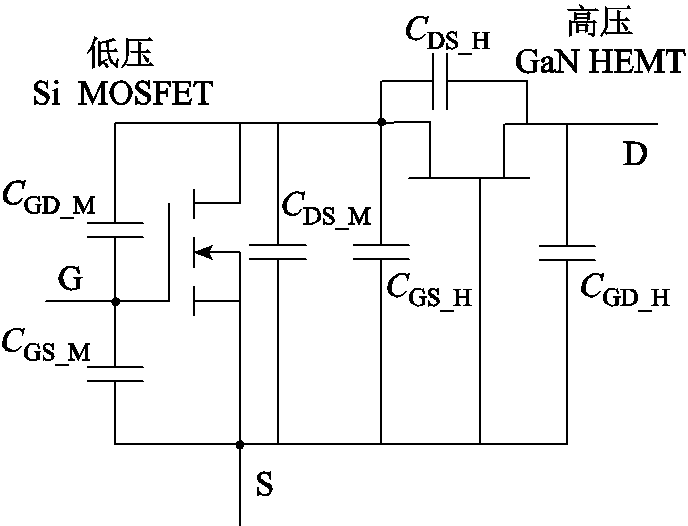
图4 Cascode GaN HEMT结构
Fig.4 Structure of Cascode GaN HEMT

图5 Cascode GAN HEMT开通过程
Fig.5 Turn-on process of Cascode GAN HEMT
(1)vGS_M<vTH_M时,其充电过程如图5a所示,由于Si器件的驱动电压vGS_M未达到开启电压vTH_M,此时Si MOSFET没有开通,其门级电流主要为CGS_M和CGD_M充电。
(2)vGS_M≥vTH_M且vGS_H<vTH_H时,如图5b所示,此时Si MOSFET开始开通,但由于GaN HEMT的门极电压vGS_H未达到其开启电压vTH_H,GaN HEMT始终保持关闭状态。这时Si MOSFET处于饱和区,其漏极电流Id_M可表示为
 (7)
(7)
式中, 为Si MOSFET的跨导。
为Si MOSFET的跨导。
(3)vGS_M≥vTH_M且vGS_H≥vTH_H,GaN HEMT和Si MOSFET均处于饱和区时,如图5c所示,GaN HEMT的漏极电流Id_H可表示为
 (8)
(8)
式中, 为GaN HEMT的跨导。
为GaN HEMT的跨导。
若在该过程中门级出现干扰,由于Si MOSFET与GaN HEMT跨导较大,对驱动电压敏感,容易产生振荡。
(4)当GaN HEMT退饱和时,可以等效为电阻,如图5d所示,Si MOSFET仍处于饱和状态,式(8)不成立,此时受控器件仅为Si MOSFET,振荡开始减小,直至Si MOSFET退饱和,如图5e所示,此时两个器件均可以等效为电阻,回路中不存在受控器件,回路抗干扰能力强,振荡自熄。
2.2.1 Cascode GaNHEMT端口分析
首先对Cascode GaNHEMT外部端口进行分析。当两个器件均处于饱和状态时,振荡产生并呈发散形式,为分析振荡发散原因,将Cascode结构电路等效为3个二端口网络级联形式,其等效电路如图6所示。

图6 Cascode结构二端口等效电路
Fig. 6 Two-port equivalent circuit of Cascode structure
网络1~3的T矩阵分别为
 (9)
(9)
 (10)
(10)
 (11)
(11)
整体网络T矩阵为
 (12)
(12)
其中

 (13)
(13)
式中,X1~X4为功率管等效寄生参数。门级电压的增大会导致跨导gm_H、gm_M增大,并且通过式(12)、式(13)可知,门级电压对vDS与iD的变化呈正相关,但是同时iG的变化与功率端的变化呈负相关,通过式(12)、式(13)无法确定哪一变量对于振荡的影响较大,需要进行内部的仿真以确定影响大小。
本文通过器件商提供的Spice模型以及Q3D软件提取功率管内部链接的寄生电感参数,搭建Saber仿真模型进行仿真,仿真参数见表1。通过仿真结果分析产生振荡的原因,同时进一步研究2.1节中式(3)过程。
表1 TPH3207WS内部等效电感
Tab.1 TPH3207WS internal equivalent inductance value(单位:nH)

参数数值 内部杂散电感Lint10.02 内部杂散电感Lint20.33 棚极寄生电感LGP2.8 内部杂散电感Lint30.2 漏极寄生电感LDP1.6 共源极寄生电感LSP0.9
根据表1中数据搭建开通过程的仿真模型如图7所示。图中,LC为功率环路寄生电感,CDC为功率输入端解耦电容,VPI为调节器输出, 为驱动放大电路输出。
为驱动放大电路输出。

图7 开通阻性负载仿真模型
Fig. 7 Simulation model of turning on resistive load
根据图7可得
 (14)
(14)
 (15)
(15)
 (16)
(16)
 (17)
(17)
 (18)
(18)
 (19)
(19)

根据式(14)~式(20)可以看出,该电路中存在较多的耦合,且各寄生电感对耦合有较大影响。通过仿真对振荡进行详细分析,母线电压为270V,开通27Ω阻性负载,仿真结果如图8所示,负载电压以及VDS出现振荡。
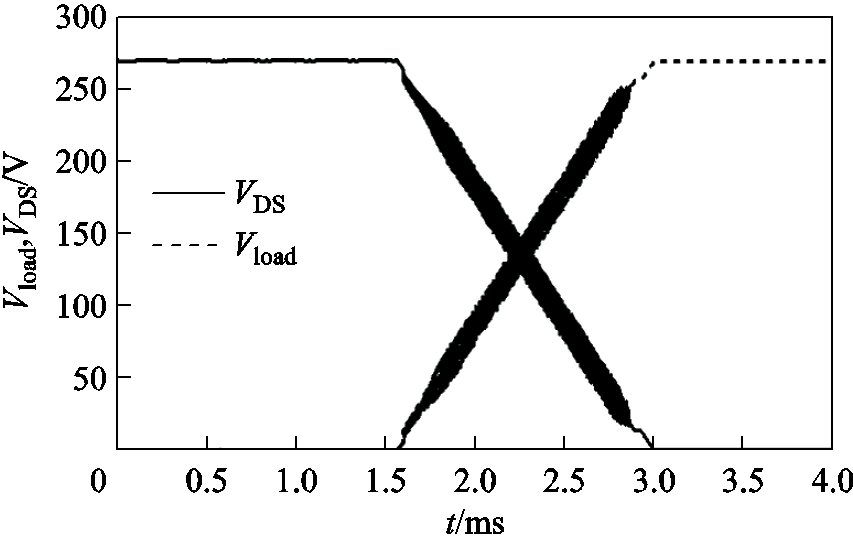
图8 开通阻性负载时负载电压、VDS振荡仿真
Fig. 8 Oscillation simulation of load voltage and VDS when resistive load is turning on
2.2.2 内部环路分析
首先对Si MOSFET及其回路进行分析。图9为该电压回路波形,其中,iG为门极电流,vGS_Cascode为功率管整体的门级电压,vGS_M为Si MOSFET门极电压,vint3和vLS分别为内部寄生电感Lint3和源极寄生电感LSP的电压,从仿真结果可得,vGS_M与vint3、vLS电压振荡方向相同,与iG振荡方向相反。且vLS振荡幅值最大,峰-峰值为3.02V,高于vint3的1.04V并与vGS_M振荡方向一致,因此,在Si MOSFET栅极环路中vLS是主要振荡源,该回路中的主要参数为共源极电感LSP。

图9 阻性负载开通时iG、vGS_M、vint3、vLS、vGS_Cascode振荡波形
Fig. 9 Oscillation waveforms of iG、vGS_M、vint3、vLS、vGS_Cascode、when resistive load is turning on
接着分析GaN HEMT环路,在门级电压vGS_H与电流波形iint2以及电流iD上均存在振荡,阻性负载开通时iint2、vGS_H、iD振荡波形如图10所示。其中vGS_H由以下几部分组成,即
 (21)
(21)

图10 阻性负载开通时iint2、vGS_H、iD振荡波形
Fig.10 Oscillation waveforms of iint2、vGS_H、iD when resistive load is turning on
GaN HEMTs门级电压vGS_H、3个寄生电感电压vint1、vint2、vint3以及Si MOSFET漏源极电压vSD_M波形如图11所示,根据仿真结果,3个寄生电感电压vint1、vint2、vint3与Si MOSFET漏源极电压vSD_M振荡方向相反,与HEMT门级电压vGS_H相同,据此推断,Cascode内部杂散电感Lint1、Lint2和Lint3造成了GaN HEMT栅极回路上的振荡。同时,vint2的峰-峰值达到11.26V,明显高于vint1的66.67mV和vint3的1V。因此vint2应为主要振荡源,Lint2为该回路重要参数。

图11 阻性负载开通时vGS_H、vint1、vint2、vint3、vSD_M振荡波形
Fig. 11 Oscillation waveforms of vGS_H、vint1、vint2、vint3、vSD_M when resistive load is turning on
根据上述仿真结果整理各个元件电压方向以及电流方向,功率端与控制端环路如图12所示。主要电压电流振荡波形如图13所示。
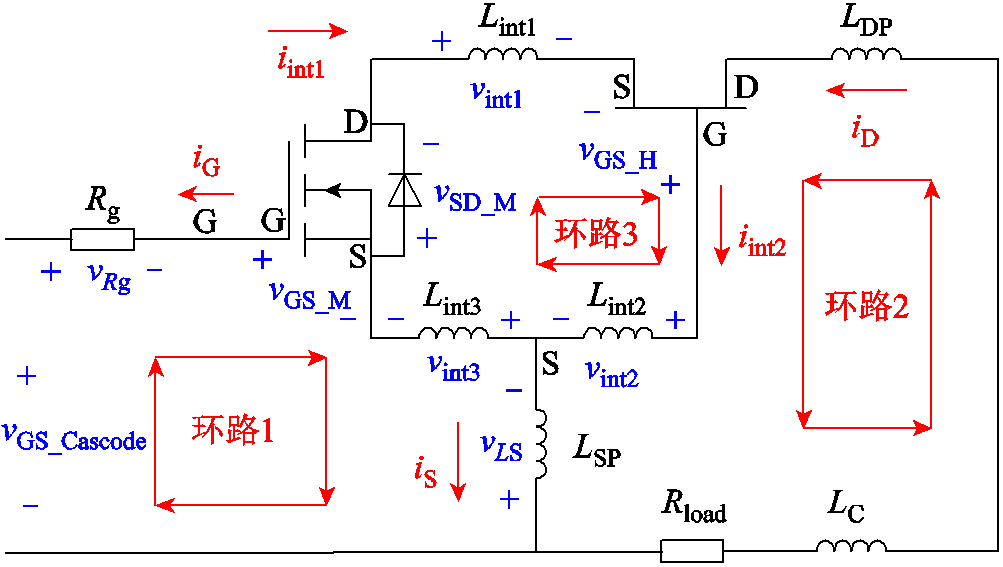
图12 功率端与控制端环路
Fig. 12 Power and control loops
首先分析回路1,由于流入Si MOSFET的门级电流iG为mA级,相较于Lint1与Lint3上的电流可忽略不记,这里可以认为流过Lint1与Lint3的电流相等,等于Si MOSFET漏极电流,统一用iint1表示,同时由于LGP为nH级别,振荡频率为MHz级别,其高频等效阻抗相对于Rg可以忽略。得到Si MOSFET门级电压vGS_M为

图13 主要电压电流振荡波形
Fig. 13 Main voltage and current oscillation waveforms
 (22)
(22)
对于环路2,由于栅极电流iG较小,所以认为iD与iS相等,即
 (23)
(23)
对于环路3,可得
 (24)
(24)
根据式(22),当vGS_M增大时,漏极电流iint1增大,在Lint3上感应电压vint3和vLS增大,而vint3和vLS增大又会导致vGS_M增大,形成了第一条电压正反馈通路。
当电流iint1增大时,Lint3上的感应电压vint3和Lint1上的感应电压vint1增大;同时,根据式(24),若iD不变,iint1增大,则iint2增大,vint2增大;由式(21),vGS_H增大,GaN HEMT漏级电流iD增大,再次造成iint2增大,形成了第二条电压正反馈通路。
若iD增大,根据式(23),iS增大,在寄生电感LSP上的电压vLS增大,由式(22),vGS_M增大,并与第二条通路相连共同形成第三条电压正反馈通路。
最后通过差分放大电路、PI调节电路、驱动放大电路将振荡返回至vGS_M。根据上述分析绘制反馈控制框图如图14所示。

图14 反馈控制框图
Fig. 14 Feedback control block diagram
图4中,存在3个正反馈支路。在功率管开通过程中,Si MOSFET处于饱和状态,跨导gm_M较大,vGS_M对iint1影响较大,而iint1对三条正反馈回路均有影响。同时该振荡又通过控制回路传导回门级。
通过第2.2节的分析可知,可行的解决方案有以下两类:
第一类,从抑制正反馈回路角度考虑,取2.2.2节分析中几个环路中关键器件参数进行改动,以减小振荡,具体措施如下:
(1)减小共源极电感LSP。在第2节分析中,正反馈过程很大程度上是由共源电感LSP上的交流电压vLS引起的,减小共源极电感LSP可以切断GaN HEMT与Si MOSFET之间的正反馈通路,对振荡有较大的衰减作用,但是该电感大小和器件封装关系紧密,在实际应用中很难改变。
(2)减小杂散电感Lint2。杂散电感Lint1与Lint2在振荡期间有相似作用,产生的vint1和vint2都会引起栅极谐振,即vGS_H。通过减小寄生电感,可以有效抑制vGS_H,从而避免振荡。根据2.2节中的分析,vint2 vint1,因此,在振荡中,Lint2会比Lint1造成更大的影响。同样,Lint1与Lint2的大小也与功率管自身封装有关,这些参数在实际应用中很难更改。
vint1,因此,在振荡中,Lint2会比Lint1造成更大的影响。同样,Lint1与Lint2的大小也与功率管自身封装有关,这些参数在实际应用中很难更改。
第二类,从抑制vGS_M振荡的角度考虑,在上述分析中可得vGS_M与多个振荡环路相关,抑制vGS_M上振荡则可以将振荡大幅减小。具体措施如下:
(1)增加RC吸收电路。由上述分析可知,抑制vGS_M的振荡可以减弱iint1对3个正反馈环路的影响。由于Si MOSFET与GaN HEMT均处在饱和状态,该过程可列写为
 (25)
(25)

式中,iD为功率管的漏极电流; 、
、 分别为Cascode GaN HEMT漏源极和栅源极寄生电容上的电流;
分别为Cascode GaN HEMT漏源极和栅源极寄生电容上的电流; 、
、 分别为Si MOSFET漏源极和栅源极寄生电容上的电流。结合式(25)、式(26)可得
分别为Si MOSFET漏源极和栅源极寄生电容上的电流。结合式(25)、式(26)可得
 (27)
(27)
若Si MOSFET和GaN HEMT的门极电压出现干扰ΔvGS_M和ΔvGS_H,式(25)、式(27)可写为
 (28)
(28)
 (29)
(29)
若要抑制振荡,则需保持iD不变,根据式(28)、式(29),可增大 来减弱ΔvGS_M和ΔvGS_H的影响。考虑在功率管漏源两端并联吸收电路以增大
来减弱ΔvGS_M和ΔvGS_H的影响。考虑在功率管漏源两端并联吸收电路以增大 ,从而抑制振荡。
,从而抑制振荡。
在Saber仿真中验证RC吸收电路对振荡的抑制作用,加RC吸收电路仿真结果对比如图15所示,图中的门极电阻为51Ω,无吸收电路,VDS和负载电压波形中存在振荡,图15b为增加吸收电路后的仿真结果,RC吸收电路参数为5.1Ω,电阻串联330pF电容,仿真中振荡明显减弱,说明该方案可以有效抑制振荡。
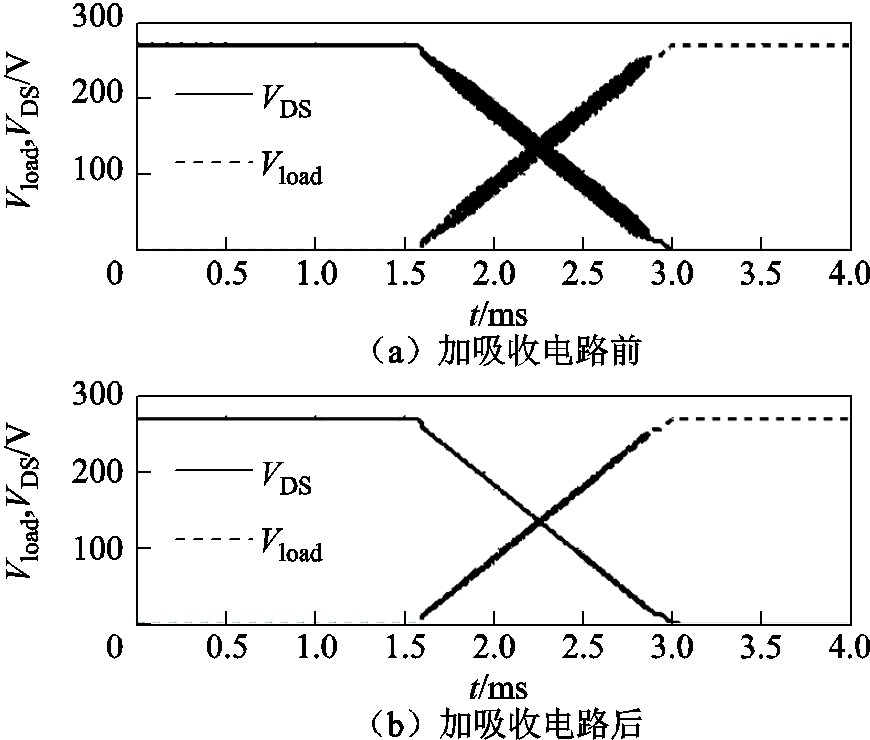
图15 加RC吸收电路仿真结果对比
Fig. 15 Comparison of simulation results of RC absorption circuit
(2)增大门级电阻。通过增大门级电阻来增大栅极阻尼,以抑制vGS_M振荡。由于SSPC对开通关断速度要求不高,所以该方案可行。在仿真中将门级电阻从51Ω增大至200Ω,振荡明显减弱。增加门级电阻仿真结果对比如图16所示。
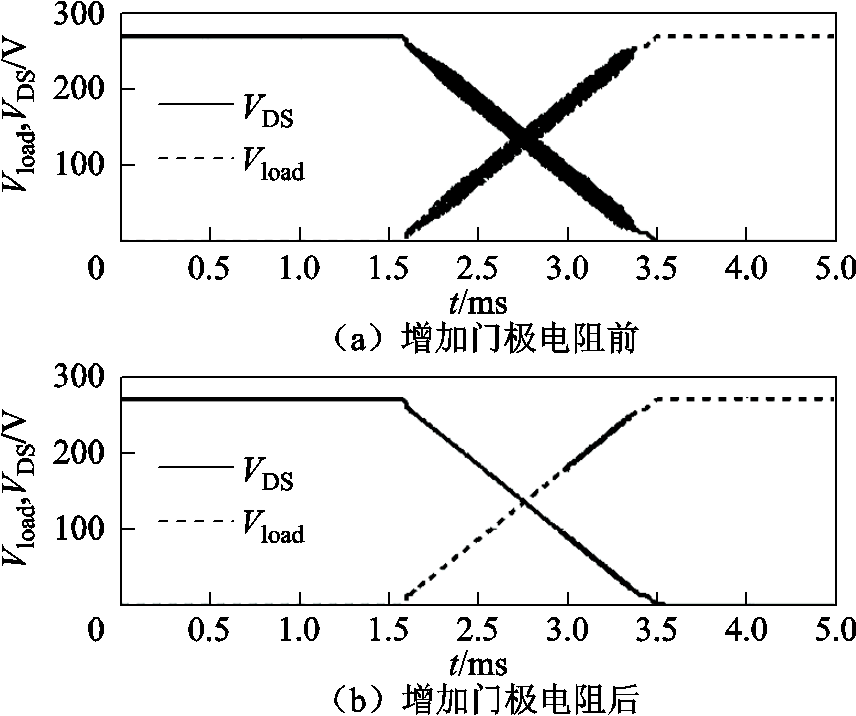
图16 增加门极电阻仿真结果对比
Fig. 16 Comparison of simulation results of adding gate resistance
针对实际应用,对于第3节中提出的抑制开关过程中振荡的两种方案,分别在70V母线电压条件下,进行了开通27Ω阻性负载实验。实验结果如图17~图19所示。

图17 增加RC吸收电路结果
Fig. 17 Results of adding RC absorption circuit
图17~图19的a图均为开通27Ω阻性负载实验结果,门级驱动电阻51Ω,未加RC吸收电路。图17b为仅增加吸收电路的开通实验结果,其中电容为330pF,电阻为5.1Ω,与图17a对比可以看出,增加RC吸收电路后振荡明显减小。说明通过增加吸收电路可以有效抑制振荡。图18b为仅增大门级电阻的开通实验结果,其中门级电阻大小为200Ω,与图18a对比可以看出,增大门极电阻可以有效抑制振荡。图19b为两种措施均施加的实验波形,其中门级电阻200Ω,RC吸收电路参数为330pF电容串联5.1Ω电阻,振荡基本消失。
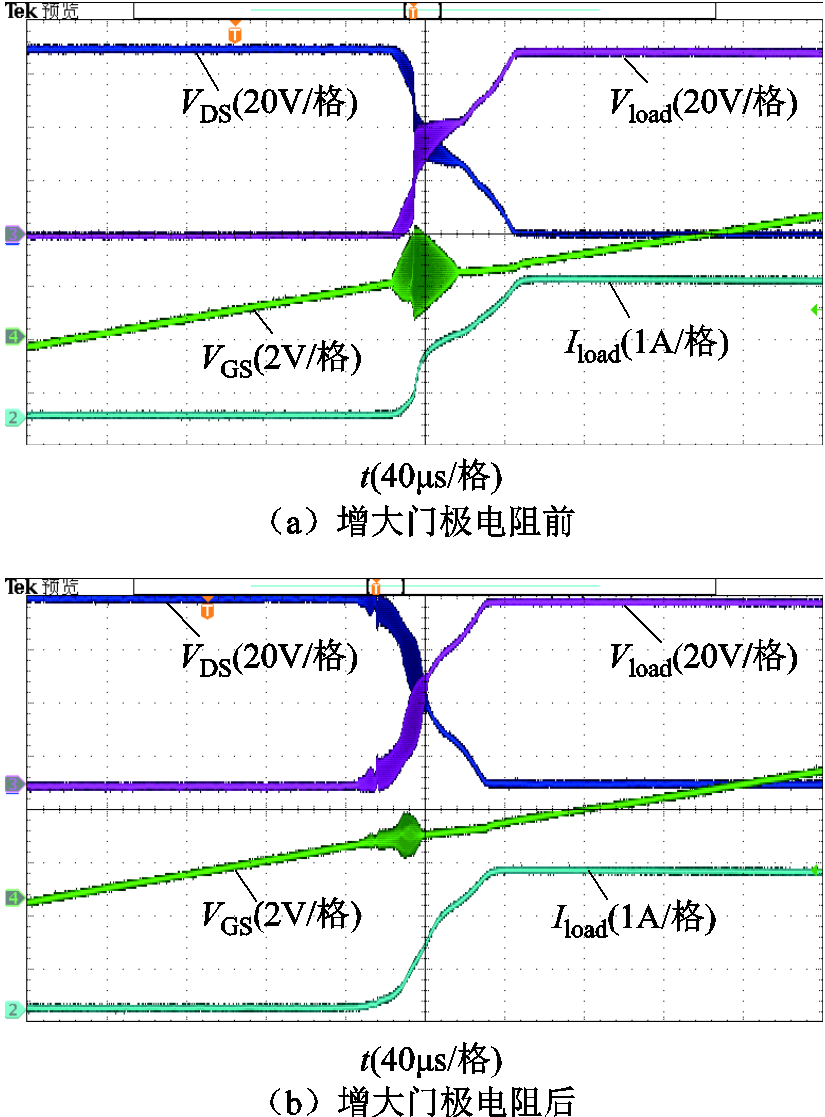
图18 增大门极电阻结果
Fig.18 Results of increasing adding gate resistance
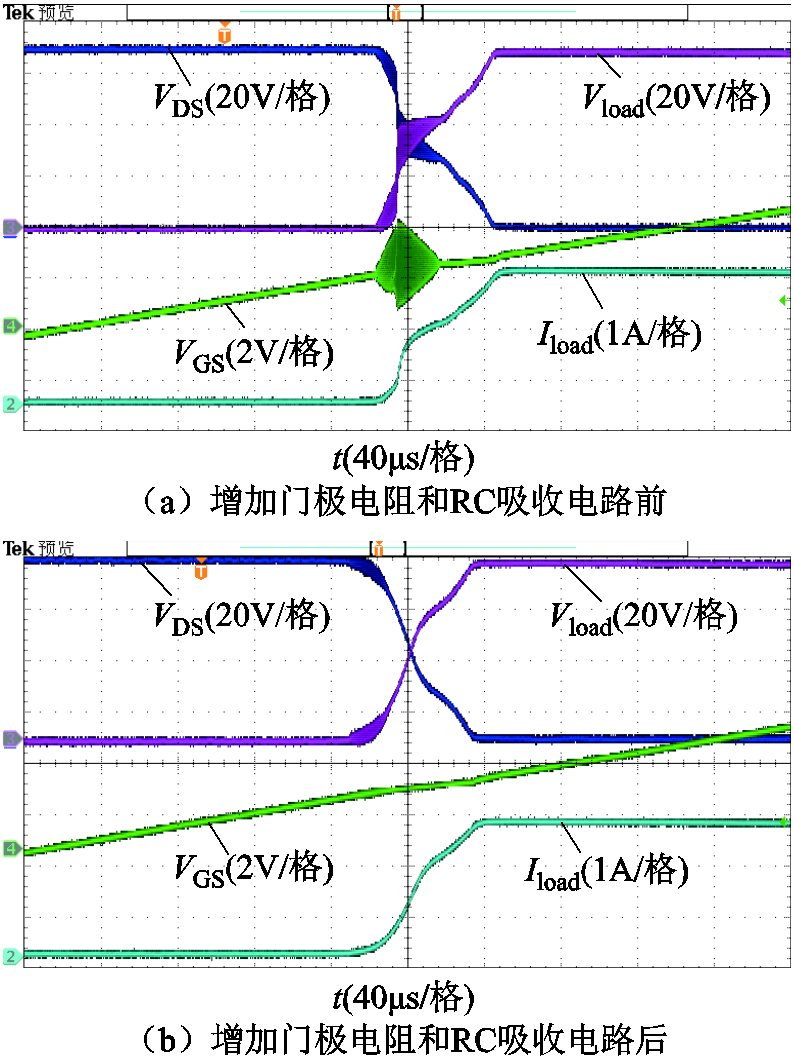
图19 同时增加门级电阻和RC吸收电路结果
Fig.19 Results of increasing adding gate resistance and adding RC absorption circuit
本文分析了直流SSPC在开通和关断过程中Cascode GaN HEMT出现的振荡问题,提出了相应的解决措施,并验证了改进效果。首先介绍SSPC“慢开通,慢关断”控制策略并对开通损耗进行了分析,然后将Cascode结构和控制策略结合,分析了功率管的开通过程,接着利用官方SPICE模型与Q3D获取内部及管脚寄生参数,并搭建仿真模型。通过对仿真中的振荡现象分析得到振荡产生的根本原因在于Cascode GaN HEMT内部存在3个正反馈回路,并分析了每个环路中的关键参数。最后根据实际应用需要,提出增大门级电阻以及并联RC吸收电路的振荡抑制方案,通过实验验证了所提方法可以有效抑制开通过程中的振荡。将振荡问题解决后可以将Cascode GaN HEMT应用于直流SSPC中以提高其可靠性,该振荡抑制方案对解决Cascode型器件类似振荡问题且有一定参考意义。
参考文献
[1] Molligoda D A, Chatterjee P, Gajanayake C J, et al. Review of design and challenges of DC SSPC in more electric aircraft[C]//IEEE 2nd Annual Southern Power Electronics Conference (SPEC), Auckland, New Zealand, 2016: 1-5.
[2] 徐洁. 多电飞机分布式智能配电技术研究[D]. 成都: 电子科技大学, 2013.
[3] Telford R D, Galloway S J, Burt G M. Evaluating the reliability & availability of more-electric aircraft power systems[C]//47th International Universities Power Engineering Conference (UPEC), London, UK, 2012: 1-6.
[4] Satoh T, Osawa K, Nitta A. GaN HEMT for space applications[C]//IEEE BiCMOS and Compound Semiconductor Integrated Circuits and Technology Symposium (BCICTS), San Diego, CA, USA, 2018: 136-139.
[5] 施媛媛. 硅基GaN功率器件缺陷相关可靠性机理研究[D]. 成都: 电子科技大学, 2019.
[6] 赵清林, 崔少威, 袁精, 等. 低压氮化镓器件谐振驱动技术及其反向导通特性[J]. 电工技术学报, 2019, 34(增刊1): 133-140.
Zhao Qinglin, Cui Shaowei, Yuan Jing, et al. Resonant drive technology and reverse conduction characteristics of low voltage GaN devices[J]. Transactions of China Electrotechnical Society, 2019, 34(S1): 133-140.
[7] 李艳, 张雅静, 黄波, 等. Cascode型GaN HEMT输出伏安特性及其在单相逆变器中的应用研究[J]. 电工技术学报, 2015, 30(14): 295-303.
Li Yan, Zhang Yajing, Huang Bo, et al. Research on output volt-ampere characteristics of Cascode GaN HEMT and its application in single-phase inverter[J]. Transactions of China Electrotechnical Society, 2015, 30 (14): 295-303.
[8] Huang Xiucheng, Liu Zhengyang, Lee F C, et al. Characterization and enhancement of high-votlage Cascode GaN devices[J]. IEEE Transactions on Electron Devices, 2015, 62(2): 270-277.
[9] 张雅静, 郑琼林, 李艳. 考虑寄生参数的高压GaN高电子迁移率晶体管的逆变器动态过程分析[J]. 电工技术学报, 2016, 31(12): 126-134.
Zhang Yajing, Zheng Qionglin, Li Yan. Dynamic analysis of inverter based on high voltage GaN high electron mobility transistor [J]. Transactions of China Electrotechnical Society, 2016, 31(12): 126-134.
[10] 黄瑞. 基于GaN的直流固态功率控制器控制与保护技术研究[D]. 南京: 南京航空航天大学, 2020.
[11] Huang Xiucheng, Du Weijing, Lee F C, et al. Avoiding divergent oscillation of a Cascode GaN device under high-current turn-off condition[J]. IEEE Transactions on Power Electronics, 2017, 32(1): 593-601.
[12] Xue Peng, Maresca L, Riccio M, et al. Investigation on the short-circuit oscillation of Cascode GaN HEMTs[J]. IEEE Transactions on Power Electronics, 2020, 35(6): 6292-6300.
[13] Xue Peng, Maresca L, Riccio M, et al. Experimental study on the short-circuit instability of Cascode GaN HEMTs[J]. IEEE Transactions on Electron Devices, 2020, 67(4): 1686-1692.
[14] Chokhawala R S, Catt J, Kiraly L. A discussion on IGBT short-circuit behavior and fault protection schemes[J]. IEEE Transactions on Industry Applications, 1995, 31(2): 256-263.
[15] 吴学超, 王莉, 阮立刚. 大功率直流SSPC短路保护关断振荡的分析与抑制[C]//中国高校电力电子与电力传动年会, 武汉, 中国, 2014: 1-4.
[16] Izquierdo D, Barrado A, Fernández C, et al. Behavioral model for solid-state power controller[J]. IEEE Aerospace and Electronic Systems Magazine, 2013, 28(12): 4-11.
Cascode GaN HEMT Switching Process Oscillation in DC Solid State Power Controller
Abstract In this paper, the oscillation problem of DC solid-state power controller (SSPC) based on Cascode Gallium Nitride high electron mobility transistor (Cascode GaN HEMT) during the turn-on process is analyzed. The SPICE model and Q3D software are used to extract the internal parasitic parameters of the Cascode structure. Combining the actual working conditions of the DC SSPC and the Cascode structure, the turn-on and turn-off process of the SSPC is simulated and analyzed in the Saber software. The simulation results show that one of the causes of the oscillation is that Cascode GaN HEMT works in the saturation region for a long time during the SSPC turn-on process, and is so susceptible to external interference to cause oscillation, and the another cause is a positive feedback loop inside . To solve this problem, the scheme of paralleling RC absorption circuit and increasing gate drive resistance is proposed. Experimental verification shows that the proposed scheme can effectively suppress the oscillation.
Keywords:Cascode GaN high electron mobility transistor (HEMT), oscillation, solid state power controller (SSPC), positive feedback
DOI:10.19595/j.cnki.1000-6753.tces.L90435
中图分类号:TM571
国家自然科学基金资助项目(51777092)。
收稿日期 2020-07-11
改稿日期 2020-12-07
赵瑞博 男,1994年生,硕士研究生,研究方向为固态配电技术。E-mail:zrb@nuaa.edu.cn
王 莉 女,1969年生,博士生导师,研究方向为为飞行器电源系统设计、控制、保护,高频电力电子集成及可靠性。E-mail:liwang@nuaa.edu.cn(通信作者)
(编辑 陈诚)