Tab.1 Type and characteristics of short-circuit

类型位置原因特征 一类短路桥臂直通 硬件失效、软件故障回路电感量较小 (nH级) 二类短路相间短路 相间短路、对地短路回路电感量较大 (mH级)
摘要 随着电力电子技术的飞速发展,SiC MOSFET以优异的材料特性在高频、高压、高温电力电子应用中展现了显著的优势。然而,SiC MOSFET较高的开关速度与较弱的短路承受能力对短路保护技术带来了新的挑战。该文首先介绍SiC MOSFET不同短路类型以及短路测试方法;其次对SiC MOSFET短路失效模式及失效机理进行分析;然后详细梳理现有SiC MOSFET短路检测与短路关断技术的原理与优缺点,讨论现有SiC MOSFET短路保护技术在应用中存在的问题与挑战;最后对SiC MOSFET短路保护技术的发展趋势进行展望。
关键词:SiC MOSFET 短路测试 短路失效 短路保护
经过半个世纪的发展,传统硅(Silicon, Si)功率半导体器件性能已达到极限,难以满足新能源装备高效、高功率密度等新的发展需求[1-4]。碳化硅(Silicon Carbide, SiC)金属-氧化物半导体场效应晶体管(Metal-Oxide-Semiconductor Field-Effect Transistor, MOSFET)具有低开关损耗、高开关频率、高耐压值以及优异的温度特性,在大功率电力电子应用中对散热器的性能要求大大降低,使得整个电力电子装置的转换效率、功率密度及稳定性大幅提升[5-6]。然而,短路故障是导致SiC MOSFET失效的重要原因之一,严重阻碍其应用[4-6]。尽管SiC MOSFET具有较好的导热性能,但与Si器件和SiC场效应晶体管的短路性能相比,SiC MOSFET的短路保护在以下几个方面更具挑战性。
首先,在相同额定电流容量下,SiC MOSFET芯片面积小、电流密度高,这就导致SiC MOSFET短路承受能力较弱[7]。在600V母线电压下对1 200V/ 33A SiC MOSFET进行硬短路测试,被测器件在约13ms后失效损坏,然而在短路发生约5ms时被测器件栅-源极泄漏电流突然增大,这表明栅-源极已经退化[7-9]。研究发现,在短路工况下,SiC MOSFET通道迁移率的正温度系数高达600K,这就导致SiC MOSFET的短路承受能力和鲁棒性明显低于SiC 结型场效应晶体管[10-11]。
其次,在短路工况下,SiC MOSFET较弱的界面质量会带来栅极氧化层可靠性问题,对SiC MOSFET的稳定工作产生负面影响[12-13]。随着制造商工艺的改进,该问题得到了有效缓解,但是短路发生时,器件结温迅速升高到125℃以上,Fowler- Nordheim沟道电流进入电介质导致栅极氧化层出现明显退化[14-16];由于SiC MOSFET需要更高的正向栅极偏压,栅电场的增高会进一步加剧短路时栅极氧化层退化问题[17-18]。
此外,为了确保SiC MOSFET可靠运行在安全工作区内,其较弱的短路承受能力就要求短路保护电路具有更快的响应速度。然而,与Si器件相比,SiC MOSFET的结电容更小、开关速度更高。SiC MOSFET独特的正温度系数跨导导致其开通时的dI/dt和dV/dt随着结温的升高均增大[19]。在较高的dI/dt和dV/dt条件下,SiC MOSFET短路保护电路的快速响应与抗噪声能力难以兼顾。
上述研究表明,SiC MOSFET短路保护难度大,短路时SiC MOSFET芯片更易受损。为了解决这一问题,国内外学者在SiC MOSFET短路保护方面做了很多工作,主要涵盖SiC MOSFET短路测试方法、失效模式与失效机理、短路检测方法以及关断策略等。因此,本文旨在全面介绍SiC MOSFET短路保护技术,加深对短路故障的理解,为科研与技术人员在高频、高效率电力电子场合更好地使用SiC MOSFET器件提供借鉴。
按短路回路电感值的大小和短路位置可将短路故障分为一类短路和二类短路,短路的类型与特征见表1。
表1 短路的类型与特征
Tab.1 Type and characteristics of short-circuit

类型位置原因特征 一类短路桥臂直通 硬件失效、软件故障回路电感量较小 (nH级) 二类短路相间短路 相间短路、对地短路回路电感量较大 (mH级)
由于短路回路电感较小,一类短路故障电流上升快,对功率器件危害大,保护难度较高。按照短路发生时刻,一类短路又可以分为硬开关故障(Hard Switching Fault, HSF)与负载故障(Fault Under Load, FUL)两类。图1所示为SiC MOSFET短路故障典型波形。可以看出,HSF发生时刻在SiC MOSFET开通瞬间,如图1a所示。当HSF发生时,漏极电流ID快速上升到最大值,然后回落至稳定的短路电流值。由于回路电感极小,漏-源极电压VDS小幅下降后又稳定在母线电压;FUL发生在SiC MOSFET完全导通之后,如图1b所示。当FUL发生时,短路电流从负载电流迅速上升,SiC MOSFET两端电压也随之上升至母线电压。不论是HSF还是FUL发生时,SiC MOSFET都承受着巨大的短路能量。由于SiC MOSFET芯片面积较小、电流密度较大,巨大的能量可能会在短时间内烧毁SiC MOSFET[20]。

图1 功率器件短路故障典型波形
Fig.1 Typical short-circuit waveforms of power semiconductor
短路测试是研究功率器件短路特性、测试短路保护电路性能的重要方法。目前常见的SiC MOSFET短路测试方法有两种,各自优缺点和适用场合见表2。
(1)基于双脉冲测试的短路测试方法。该方法使用“粗短铜排”代替双脉冲测试电路中的负载电感来模拟短路,如图2a所示。当脉冲发生器向驱动器1发送高电平信号时,打开上桥臂SiC MOSFET,再向驱动器2发送高电平信号,就可以实现HSF;当脉冲发生器向驱动器2发送一个信号使待测SiC MOSFET正常开启时,再向短路控制开关S1发送闭合信号使故障电感LFault接入功率回路,就可以实现FUL。
表2 SiC MOSFET短路测试方法对比
Tab.2 Comparison of SiC MOSFET short-circuit tests

类型优缺点适用场合 基于双脉冲测试的短路测试方法优点:模拟真实短路工况缺点:易对被测器件造成损坏适用于短路保护电路性能测试 基于非线性元件的无损短路测试方法优点:有效保护被测器件缺点:不能真实反映短路工况适用于器件短路性能测试
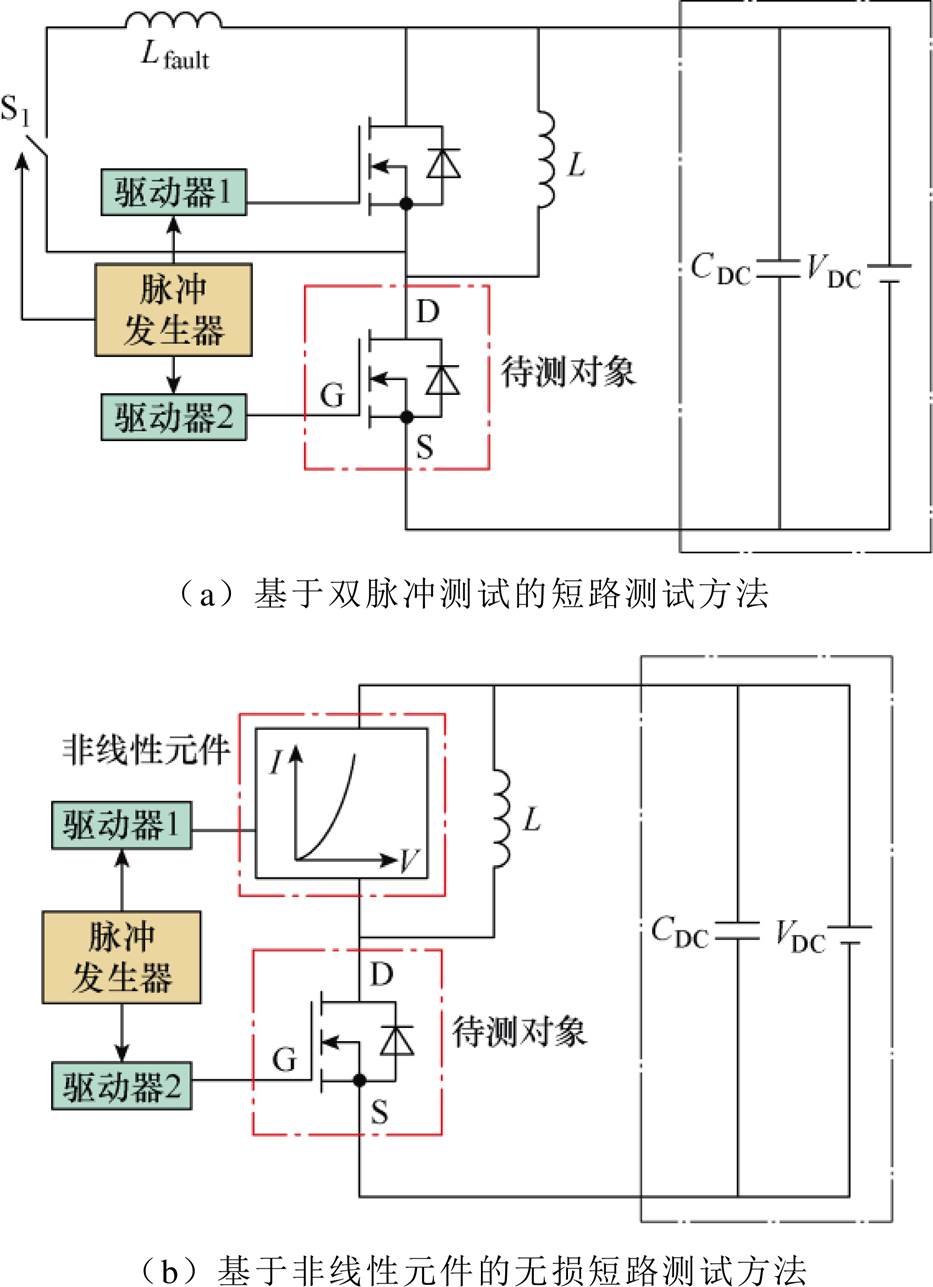
图2 不同的SiC MOSFET短路测试方法
Fig.2 Different short-circuit test methods for SiC MOSFET
(2)基于非线性元件的无损短路测试方法。不同的SiC MOSFET短路测试方法如图2所示。该方法是在被测SiC MOSFET的短路回路中串入非线性元件[21-22],如图2b所示。非线性元件在额定电流时内阻较低,与SiC MOSFET相比饱和电流更小。当脉冲发生器通过驱动器1开启该非线性元件时,再通过驱动器2开启待测器件就可以模拟HSF。当短路电流达到该元件的饱和电流时,短路电流就会被限制。当短路电流持续增大时,该元件就会“熔断”。
基于双脉冲测试的短路测试方法可以真实地模拟实际短路工况,但开关S1的引入不仅使成本和控制逻辑复杂性大幅增加,额外的寄生电感也使得对寄生电感更为敏感的SiC MOSFET短路测试风险增加。此外,由于短路回路阻抗小,短路电流上升速率快,很容易对SiC MOSFET造成损坏,所以该方法主要用于SiC MOSFET短路保护电路性能测试。
基于非线性元件的无损短路测试方法可以很好地保护被测SiC MOSFET,避免严重损坏。为观测SiC MOSFET短路现象、研究失效机理以及芯片工艺改进保留有效的实验样本,但是非线性元件的引入使该测试不能真实地模拟短路故障。此外,非线性元件的选型以及成本也不容忽视。
目前,SiC MOSFET的短路失效模式主要有栅-源极失效和热逃逸失效[23-33],两者的失效条件、原因及特征详见表3。
表3 SiC MOSFET短路失效模式对比
Tab.3 Comparison of SiC MOSFET short-circuit failure mode

失效类型失效条件失效原因失效特征 栅-源极失效较低短路能量高温熔化的源极铝金属散入栅极氧化层出现的裂纹中致使栅-源短路栅-源极阻抗下降 热逃逸失效较高短路能量短路高温和泄漏电流激活了内部寄生BJT致使漏-源极电流失控器件短路性能测试
图3为SiC MOSFET(DF23MR12W1M1)在母线电压Vdc=400V、栅-源极电压Vgs=20V时的短路测试波形。在短路持续16ms后关断SiC MOSFET,关断后的SiC MOSFET出现了栅-源极失效现象。在栅-源极失效前,随着短路时间增加,栅-源极电压明显下降,短路电流出现拖尾。在栅-源极失效后,栅-源极短路但漏-源极完好,观察SiC MOSFET芯片表面上没有明显可见损伤,但是在电子显微镜下,可以观察到栅极多晶硅和源极铝之间的栅极层间电介质中出现了裂纹。利用能量色散谱仪对裂纹处元素进行分析,可以观测到裂纹上方的源区大量铝迁移到了裂纹中[23],SiC MOSFET栅-源极失效后的芯片如图4所示。
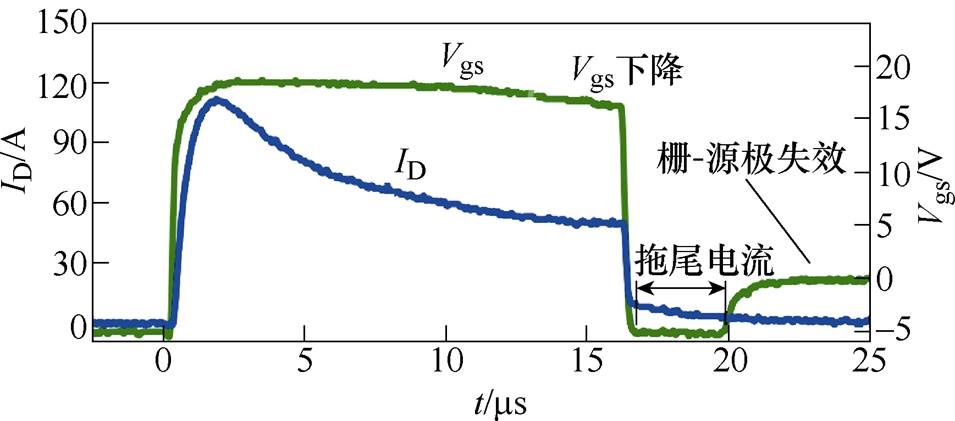
图3 SiC MOSFET短路波形(Vdc=400V、Vgs=20V)
Fig.3 Short-circuit test waveforms of SiC MOSFET (Vdc=400V, Vgs=20V)
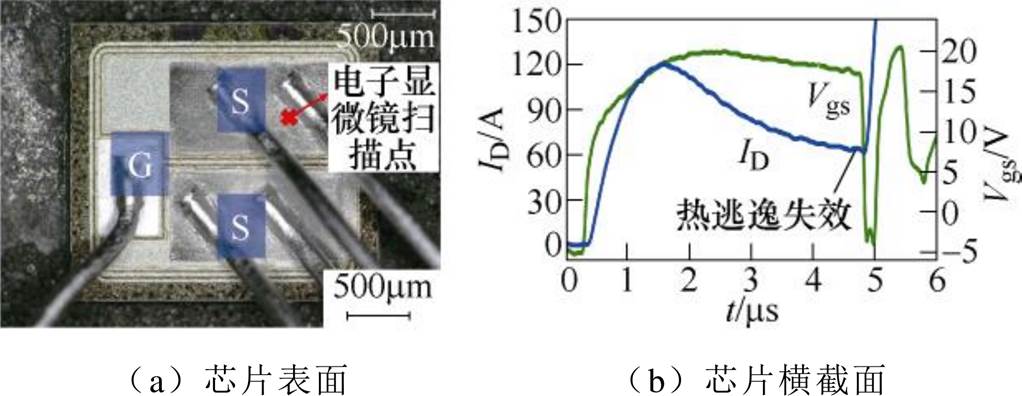
图4 SiC MOSFET栅-源极失效后的芯片
Fig.4 Photos of the SiC MOSFET’ chip after gate failure
研究表明,较大的短路电流导致器件结温迅速升高,而SiC MOSFET栅极氧化层较薄且内部材料的热膨胀系数不一致导致栅极氧化层在高温时出现裂纹[24-26]。当器件结温超过源极金属铝的熔点时,被高温熔化的源极铝金属将散入裂纹中导致SiC MOSFET栅极与源极短路,使其呈现低阻特性[27-28]。因此,SiC MOSFET栅-源极失效是高温和热应力的共同作用结果。由于Si MOSFET热逃逸温度阈值较低,栅-源极失效现象只会出现在高温半导体器件中,如SiC、GaN器件。
热逃逸又称热失控,是器件内部温度升高到一定程度后引起器件劣化使温度进一步升高,最终导致某一种破坏性的结果[29]。图5为SiC MOSFET(DF23MR12W1M1)在母线电压800V、栅-源极电压20V时的短路测试波形。可以看到,在短路出现不到5ms时发生了热逃逸失效,短路电流失去控制持续上升,直至SiC MOSFET烧毁。热逃逸发生前,SiC MOSFET栅-源极电压出现了下降,说明栅-源极阻抗已经下降。
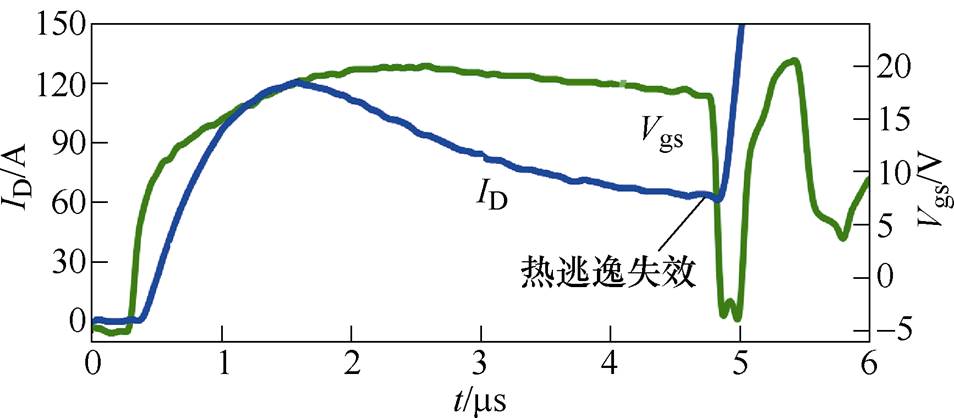
图5 SiC MOSFET短路测试波形(Vdc=800V、Vgs=20V)
Fig.5 Short-circuit test waveforms of SiC MOSFET (Vdc=800V, Vgs=20V)
SiC MOSFET热逃逸失效与短路关断过程中产生的漏极泄漏电流有很大关系。当短路时间达到一定程度时,SiC MOSFET就会出现漏极泄漏电流,且随着短路时间的增加,泄漏电流愈加明显[30-31]。当短路时间小于SiC MOSFET短路耐受时间时,即使在关断时出现泄漏电流,泄露电流也会逐渐降低,SiC MOSFET不会发生热逃逸,但当短路时间大于等于短路耐受时间时,就会触发热逃逸。研究表明,SiC MOSFET热逃逸的原因是短路高温和泄漏电流激活了内部寄生双极结型晶体管致使漏-源极电流失控[32-34]。
通过介绍两种失效模式的现象和成因不难看出,短路能量较低时可能会导致SiC MOSFET栅-源极失效,而短路能量较高时可能会使SiC MOSFET发生热逃逸失效。SiC MOSFET栅-源极失效时不一定会发生热逃逸失效,但是热逃逸失效发生时必定伴随有栅-源极失效。
SiC MOSFET较弱的短路承受能力需要短路保护电路快速动作,但是较高的开关速度、开关振荡以及关断过电压都给SiC MOSFET短路保护带来了巨大挑战[35]。为了确保SiC MOSFET安全可靠工作,快速可靠的短路检测与短路关断技术成为国内外学者研究的热点问题。
目前,针对SiC MOSFET的短路检测技术主要有退饱和检测、寄生电感电压检测、电流传感器法、分流器检测、镜像电流检测和栅极电荷检测六种,SiC MOSFET短路检测方法见表4。下面将对上述方法的工作原理、优势及存在的问题进行详细介绍。
1)退饱和检测
退饱和检测原理简单、成本低,广泛应用于绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor, IGBT)短路保护中,但在SiC MOSFET的短路保护中采用该方法存在巨大挑战[7, 36-41],二极管式退饱和检测如图6所示。
图6a为二极管式退饱和检测电路。在SiC MOSFET导通时,当A点电压VA上升超过阈值Vth1时,比较器翻转发出故障信号关断器件。在SiC MOSFET关断时,晶体管VT1导通将A点电压下拉至低电平,检测电路被屏蔽。该检测电路工作原理如图6b所示,PWM为高时,SiC MOSFET开始导通,在完全导通前,由于SiC MOSFET漏极电压值较高,二极管(VDS1, …)反向截止,VCC通过Rblk对Cblk充电,A点电压升高。在SiC MOSFET完全导通之前,需要预留足够的盲区时间Tbl防止检测电路误触发。当SiC MOSFET发生短路退出“饱和”状态时,VA将上升超过阈值Vth1导致比较器翻转。
表4 SiC MOSFET短路检测方法
Tab.4 Short-circuit detection method of SiC MOSFET

短路检测方法优势劣势 退饱和检测二极管式[35-41]简单、成本低存在盲区、易误触发 寄生电感电压检测di/dt检测[41]无盲区HSF易误触发 电流评估法[45]无盲区、可靠FUL电流峰值较高 两级RC型电流评估法[46]无盲区、可靠成本高 RCD型电流评估法[47]无盲区、可靠FUL电流峰值较高 电流传感器霍尔器件[7]方便、无盲区精度低 PCB型罗氏线圈[48-50]精度高电路复杂 分流器检测同轴分流器[7, 36]精度高损耗大、成本高 非线性元件[23]可变保护阈值成本高、安装不便 栅极电荷检测[36, 43, 53]HSF响应快电路复杂、FUL不适用
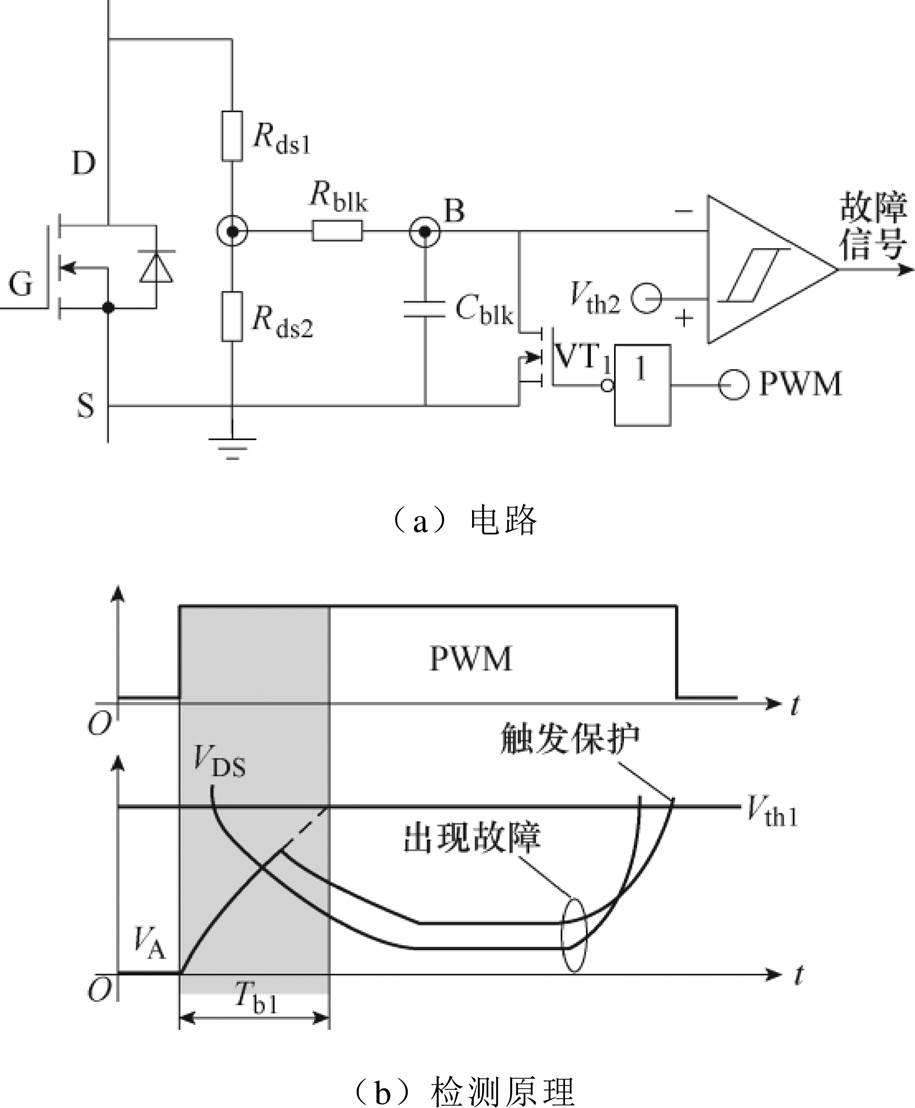
图6 二极管式退饱和检测
Fig.6 Desaturation technique with sensing diodes
在SiC MOSFET完全开通后,A点电压VA的大小可以表示为
 (1)
(1)
式中,VD为二极管正向导通压降。
可以看出,A点电位由SiC MOSFET导通压降以及二极管的压降决定。然而,在中大功率SiC MOSFET应用中,SiC MOSFET导通压降较高,然而较高的母线电压就需要多个二极管串联来提高反向击穿耐压,这就导致A点电位升高很可能触及阈值Vth1,进而引起检测电路误触发。此外,SiC MOSFET开通瞬间漏-源极电压振荡也增加了检测电路误触发的风险。
此外,业内公认IGBT具有约10ms的短路承受时间,但对于SiC MOSFET的短路承受时间,各大功率半导体器件厂商都没有形成共识。英飞凌对外宣称其Cool SiC MOSFET具有3ms的短路承受时 间[36],基本半导体的SiC MOSFET短路承受时间则为6ms[37],CREE和Rohm公司的SiC MOSFET短路承受时间约为2ms[7, 38]。然而,商用SiC MOSFET驱动器检测盲区几乎都在ms级别,例如,CREE公司的PT62SCMD17检测盲区时间为1ms[32],虽然该数值在器件厂商所提供的短路承受时间之内,但相比于SiC MOSFET的短路承受时间,ms级别的检测盲区使得退饱和检测的响应速度显的杯水车薪。研究表明,SiC MOSFET即使承受1ms以内的短路应力,其电学特性也会发生退化[39-40],承受的短路时间越长、短路次数越多,SiC MOSFET的电参数退化现象越明显[41-42]。因此,当SiC MOSFET发生短路时,应该在第一时间进行短路保护动作,检测盲区的存在不仅会造成SiC MOSFET短路时的电参数退化进而影响开关性能,还会大大增加SiC MOSFET短路失效的风险。
2)寄生电感电压检测
SiC MOSFET模块功率源极和辅助源极之间存在寄生电感,电流的变化会在寄生电感上感应出一个电压值[43-44]。由于短路时SiC MOSFET电流变化率dID/dt较大,因此可以通过检测感应电压值来检测短路故障,最典型的方法就是dI/dt检测,如图7a所示。图7b为dI/dt检测技术的工作原理,在正常开通过程中,快速上升的电流在LSS上感应出一个负向电压VSS,该电压值与电流变化率成正比。当发生短路故障时,ID迅速上升,负向VSS触发保护阈值Vth3,短路器件被关断。dI/dt检测时间短、易于集成在驱动芯片中,但对寄生电感引起的噪声特别敏感。此外,由于SiC MOSFET开通时较高的dID/dt会感应出较大的负向VSS,也可能触发阈值Vth3导致保护电路误触发。

图7 dI/dt检测技术
Fig.7 dI/dt test technique
鉴于此,华中科技大学Wang Zhiqiang等提出了基于电流评估的短路检测电路,将寄生电感上感应的电压利用RC积分电路得到对应电流值来实现短路检测[45],电流评估短路保护如图8所示,SiC MOSFET漏极电流ID与输出电压VO的关系为
 (2)
(2)
可以看出,输出电压VO随着ID的增大而增加,当VO达到阈值Vth时触发比较器。将SiC MOSFET寄生电感上的感应电压转换成电流进行短路保护,可以有效地避免开通电流上升斜率过大引起的误触发问题,但也存在一定缺陷。图8b中,t1时刻,SiC MOSFET正常开通,-VO随ID增大而呈比例上升,RC积分器可以正常“记录”电流上升。但t2时刻后,ID增大上升至负载电流水平,dID/dt趋近于零,Cf通过LSS和Rf放电,-VO逐渐减小。到t3时刻,VO趋近于零。当t4时刻出现短路故障时,短路电流将在负载电流的基础上快速上升,但-VO却是从零上升,由于HSF和FUL使用的是同一阈值,因此FUL电流峰值将远大于HSF。

图8 电流评估短路保护
Fig.8 Current evaluation short-circuit protection
为此,美国弗吉尼亚理工大学Wang Jun团队提出了两级RC型短路保护电路对HSF和FUL进行单独检测[46],改进的电流评估短路保护电路如图9所示。通过加入电感Lo来减缓FUL时Co放电现象。电感Lo越大、Co放电越慢,但当FUL发生时刻大于一定值时,Co电位下降至零。此外,较大的电感值也会减缓Co充电过程,导致FUL保护响应时间变慢。为此,河北工业大学Xin Zhen等则进一步对上述方案进行了改进,如图9b所示[47]。利用二极管VDblo的单向导电性来防止电容Cs放电,很好地解决了FUL发生时刻的不确定性所导致的Cs放电现象,但是电阻Rblo过大会同样导致HSF和FUL保护响应时间变慢。

图9 改进的电流评估短路保护电路
Fig.9 Improved current evaluation short-circuit protection circuit
3)电流传感器
电流传感器广泛应用在电力设备电流测量中,如霍尔器件、罗氏线圈等,其原理简单且可靠性高,功率回路和测量回路具备电气隔离,但带宽较低、体积较大,不适用于高频、高功率密度的SiC MOSFET短路保护应用。为此,Wang Jun等设计了一种适用于SiC MOSFET模块短路保护的PCB型罗氏线圈[48-50],如图10所示。不仅方便安装,高达200MHz的带宽可以对SiC MOSFET模块漏极电流进行准确的采集,为SiC MOSFET模块短路保护提供可靠保障。然而,为了提高测量宽带获得更加精确的漏极电流,在PCB型罗氏线圈设计中需要增加线圈匝数。但是由于SiC MOSFET应用在高频开关工况,增加PCB线圈匝数会严重影响其抗扰动性能,可能导致短路保护电路误触发。此外,PCB型罗氏线圈的信号还原电路实现较为复杂,严重阻碍了该方法的应用。

图10 适用于SiC MOSFET模块的PCB型罗氏线圈
Fig.10 A Rogowski coil for SiC MOSFET module based on PCB
4)分流器检测
分流器检测通常在功率回路串入电阻、同轴分流器等线性元件来进行短路保护[43]。在SiC MOSFET的短路保护中通常采用精度更高、响应速度更快且可靠性较高的同轴分流器。但是随着功率回路电流的增加,同轴分流器所带来的功耗以及高昂的成本不容忽视。为了解决该缺陷,北卡罗来纳州立大学B. J. Baliga教授团队将Si MOSFET串入SiC MOSFET回路作为“分流器”[21],基于Si MOSFET非线性特性的短路保护电路如图11所示,利用Si MOSFET漏极电压和漏极电流成正比的特性,将漏极电压作为SiC MOSFET短路检测的依据。此外,通过给Si MOSFET栅-源极施加不同的偏置电压,可以灵活调整其饱和电流来限制短路电流,防止SiC MOSFET短路损坏,但是Si MOSFET选型十分关键,在大电流应用场合,较高的损耗与成本使得该方法应用受到限制。
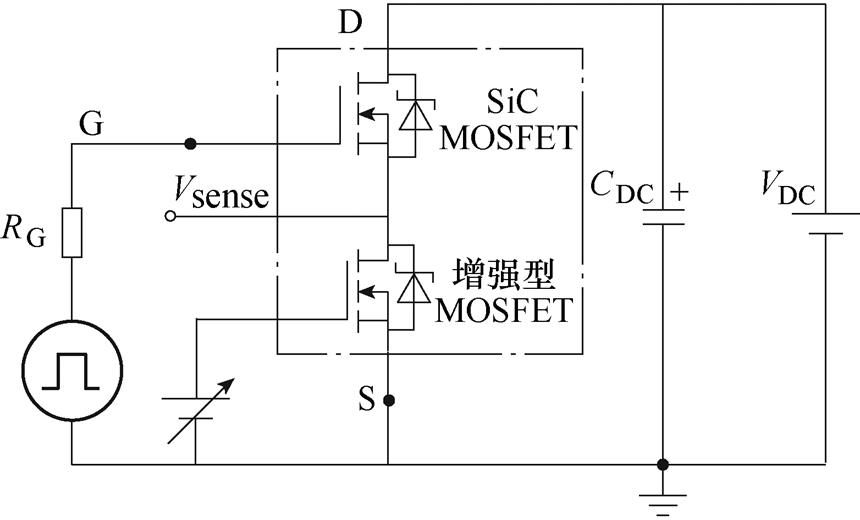
图11 基于Si MOSFET非线性特性的短路保护电路
Fig.11 Short-circuit protection circuit based on Si MOSFET’s nonlinear characteristic
5)栅极电压检测
由于HSF发生时,SiC MOSFET的栅极电荷值QG远小于正常开通过程中栅极电荷值,导致HSF发生时栅极电压VGS大于正常开通过程[50],栅极电压检测原理如图12所示,因此通过检测SiC MOSFET开通过程中栅极电压可以间接检测HSF[43, 51]。该方法优点是无检测盲区。然而,SiC MOSFET的密勒电容较小,HSF发生时栅极电压特征差异不明显,采用该方法容易造成保护电路误触发。其次,FUL时SiC MOSFET栅极电压已经为最大正向电压,因此该方法不能对FUL进行检测。
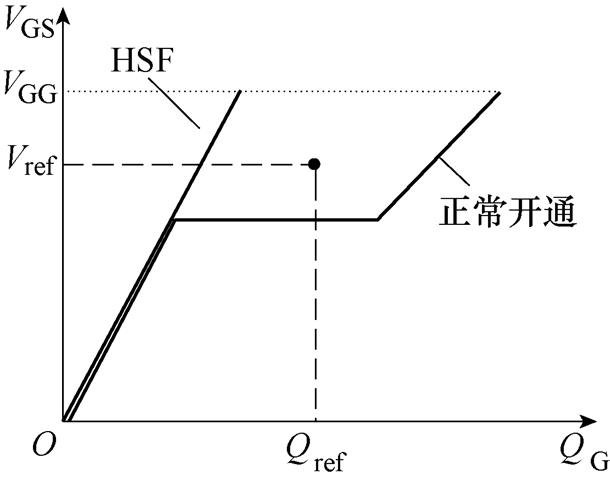
图12 栅极电压检测原理
Fig.12 Principle of gate voltage detection
当检测电路检测到短路故障后应快速关断SiC MOSFET。然而,快速的关断势必会引起较高的关断过电压,导致SiC MOSFET因过电压而损坏。防止关断过电压的常用方法就是采用软关断技术[52-61],常见短路软关断技术有两种:
(1)大电阻关断。大电阻关断是在检测到短路后,利用大阻值栅电阻来减缓关断电流下降速率从而实现关断过电压的抑制[53-57]。然而,大电阻关断在抑制关断过电压的同时也致使关断延迟时间增大,导致SiC MOSFET不能及时关断。为此,文献[58-59]提出基于多级栅电阻的软关断策略,在关断过程中采用不同栅极电阻关断SiC MOSFET短路电流,从而兼顾了SiC MOSFET短路关断过电压与关断延迟时间,但大电阻关断可能导致SiC MOSFET因关断损耗过大而发生失效。
(2)降栅压关断。降栅压关断是在检测到短路后,先缓慢降低栅极电压,使SiC MOSFET维持导通状态。在较低栅极电压下,SiC MOSFET漏极电流会被限制在较低水平,经过一定延迟后,再采用负压关断短路电流[60-61]。该方法通过缓降栅压抑制短路电流,从而降低短路关断过电压,但是该方法需要多种栅极电压,电路结构实现复杂。
通过上述分析可知,SiC MOSFET高速开关特性以及现有工艺技术导致其短路承受能力较弱,而现有短路保护技术普遍存在响应速度慢、易误触发、电路复杂以及成本高等缺点,这些问题严重威胁SiC MOSFET的安全运行,阻碍SiC MOSFET的广泛应用。因此,未来的挑战与研究课题主要涉及以下几个方面:
1)SiC MOSFET短路承受能力提升。栅极可靠性问题严重制约着SiC MOSFET为代表的宽禁带半导体器件短路承受能力。随着科学技术的发展,新的器件结构、新的制造工艺和新兴材料的研发将是提升其栅极可靠性、改善短路承受能力的关键所在。
2)SiC MOSFET的短路检测技术。相比于IGBT,SiC MOSFET开关速度更快,短路承受能力较弱,电磁干扰更严重。因此,现有短路检测方法已不能满足SiC MOSFET应用中短路检测的技术需求,研发适用于SiC MOSFET的快速、可靠短路检测技术将是未来研究方向之一。
3)SiC MOSFET短路关断策略。SiC MOSFET短路承受能力弱,短路时需要快速关断短路电流,而较快的电流变化很可能导致SiC MOSFET因过电压击穿而损坏。传统短路软关断策略不能权衡关断损耗和关断过电压之间关系,很可能造成SiC MOSFET在软关断过程中发生热逃逸或栅极失效。因此,权衡关断损耗和过电压的SiC MOSFET短路关断策略也将是未来研究课题之一。
参考文献
[1] 盛况, 郭清, 张军明, 等. 碳化硅电力电子器件在电力系统的应用展望[J]. 中国电机工程学报, 2012, 32(30): 1-7.
Sheng Kuang, Guo Qing, Zhang Junming, et al. Development and prospect of SiC power devices in power grid[J]. Proceedings of the CSEE, 2012, 32(30): 1-7.
[2] 吴海富, 张建忠, 赵进, 等. SiC MOSFET短路检测与保护研究综述[J]. 电工技术学报, 2019, 34(21): 4519-4528.
Wu Haifu, Zhang Jianzhong, Zhao Jin, et al. Review of short-circuit detection and protection of Silicon carbide MOSFETs[J]. Transactions of China Elec- trotechnical Society, 2019, 34(21): 4519-4528.
[3] Yang Yuan, Wen Yang, Gao Yong. A novel active gate driver for improving switching performance of high-power SiC MOSFET modules[J]. IEEE Transa- ctions on Power Electronics, 2019, 34(8): 7775-7787.
[4] 周林, 李寒江, 解宝, 等. SiC MOSFET的saber建模及其在光伏并网逆变器中的应用和分析[J]. 电工技术学报, 2019, 34(20): 4251-4263.
Zhou Lin, Li Hanjiang, Xie Bao, et al. Saber modeling of SiC MOSFET and its application and analysis in photovoltaic grid-connected inverter[J]. Transactions of China Electrotechnical Society, 2019, 34(20): 4251-4263.
[5] 邵伟华, 冉立, 曾正, 等. SiC MOSFET短路特性评估及其温度依赖性模型[J]. 中国电机工程学报, 2018, 38(7): 2121-2131.
Shao Weihua, Ran Li, Zeng Zheng, et al. Short-circuit evaluation and temperature-dependent model of SiC MOSFET[J]. Proceedings of the CSEE, 2018, 38(7): 2121-2131.
[6] Wen Yang, Yang Yuan, Gao Yong. Active gate driver for improving current sharing performance of paral- leled high-power SiC MOSFET modules[J]. IEEE Transa- ctions on Power Electronics, 2021, 36(2): 1491-1505.
[7] 曾正. SiC功率器件的封装测试与系统集成[M]. 北京: 科学出版社, 2020.
[8] An J, Namai M, Yano H, et al. Investigation of robustness capability of -730V p-channel vertical SiC power MOSFET for complementary inverter appli- cations[J]. IEEE Transactions on Electron Devices, 2017, 64(10): 4219-4225.
[9] Fursin L, Li Xin, Li Zhi, et al. Reliability aspects of 1200V and 3300V Silicon carbide MOSFETs[C]// 2017 IEEE 5th Workshop on Wide Bandgap Power Devices and Applications (WiPDA), Albuquerque, 2017: 373-377.
[10] Wang Zhiqiang, Shi Xiaojie, Leon M, et al. Temperature-dependent short-circuit capability of Silicon carbide power MOSFETs[J]. IEEE Transa- ctions on Power Electronics, 2016, 31(2): 1555-1566.
[11] Huang Xing, Wang Gangyao, Li Yingshuang, et al. Short-circuit capability of 1200V SiC MOSFET and JFET for fault protection[C]//2013 Twenty-Eighth Annual IEEE Applied Power Electronics Conference and Exposition (APEC), Long Beach, 2013: 197-200.
[12] Wang Huai, Blaabjerg F. Power electronics reliability: state of the art and outlook[J]. IEEE Journal of Emerging and Selected Topics in Power Electronics, 2021, 9(6): 6476-6493.
[13] Yu Liangchun, Dunne G T, Matocha K S, et al. Reliability issues of SiC MOSFETs: a technology for high-temperature environments[J]. IEEE Transactions on Device & Materials Reliability, 2010, 10(4): 418-426.
[14] Dasgupta S, Kaplar R J, Marinella M J, et al. Analysis and prediction of stability in commercial, 1200V, 33A, 4H-SiC MOSFETs[C]//2012 IEEE International Reliability Physics Symposium (IRPS), Anaheim, 2012: 331-335.
[15] Kaplar R J, Marinella M J, Dasgupta S, et al. Characterization and reliability of SiC- and GaN- based power transistors for renewable energy applications[C]//2012 IEEE Energytech, Cleveland, 2012: 1-6.
[16] Brid M W, Aune R P, Thomas A F, et al. Temperature-dependent mechanical and long crack behavior of zirconium diboride-Silicon carbide com- posite[J]. Journal of the European Ceramic Society, 2012, 32(12): 3453-3462.
[17] Nguten T, Ahmed A, Thang T V, et al. Gate oxide reliability issues of SiC MOSFETs under short-circuit operation[J]. IEEE Transactions on Power Electronics, 2015, 30(5): 2445-2455.
[18] Romang G, Fayyaz A, Riccio M, et al. A com- prehensive study of short-circuit ruggedness of Silicon carbide power MOSFETs[J]. IEEE Journal of Emerging & Selected Topics in Power Electronics, 2016, 4(3): 978-987.
[19] Chbili Z, Matsuda A, Chbili J, et al. Modeling early breakdown failures of gate oxide in SiC Power MOSFETs[J]. IEEE Transactions on Electron Devices, 2016, 63(9): 3605-3613.
[20] Boige F, Tremouilles D, Richardeau F. Physical origin of the gate current surge during short-circuit operation of SiC MOSFET[J]. IEEE Electron Device Letters, 2019, 40(5): 666-669.
[21] Knanle A, Baliga B J. Comparison of current suppression methods to enhance short-circuit capa- bility of 1.2kV SiC power MOSFETs: a new approach using a series-connected, gate-source-shorted si depletion-mode MOSFET vs use of a series resistance[C]//2019 IEEE 7th Workshop on Wide Bandgap Power Devices and Applications (WiPDA), Raleigh, 2019: 53-58.
[22] Kanala A, Baliga B J. A new user-configurable method to improve short-circuit ruggedness of 1.2kV SiC power MOSFETs[J]. IEEE Transactions on Power Electronics, 2021, 36(2): 2059-2067.
[23] Yao K, Yano H, Tadano H, et al. Investigations of SiC MOSFET short-circuit failure mechanisms using electrical, thermal, and mechanical stress analyses[J]. IEEE Transactions on Electron Devices, 2020, 67(17): 4328-4334.
[24] Liu Jingcun, Zhang Guoqang, Wang Bixuan, et al. Gate failure physics of SiC MOSFETs under short-circuit stress[J]. IEEE Electron Device Letters, 2020, 41(1): 103-106.
[25] Wei Jiaxing, Liu Siyang, Yang Lanlan, et al. Com- prehensive analysis of electrical parameters degra- dations for SiC power MOSFETs under repetitive short-circuit stress[J]. IEEE Transactions on Electron Devices, 2018, 34(3): 2771-2780.
[26] Wang Jun, Jiang Xi, Li Zongjian, et al. Short-circuit ruggedness and failure mechanisms of Si/SiC hybrid switch[J]. IEEE Transactions on Power Electronics, 2019, 34(3): 2771-2780.
[27] Sadik D P, Colmenares J, Tolstoy G, et al. Short- circuit protection circuits for Silicon-carbide power transistors[J]. IEEE Transactions on Industrial Elec- tronics, 2016, 63(4): 1995-2004.
[28] Du H, Reigosa P D, Ceccarelli L, et al. Impact of repetitive short-circuit tests on the normal operation of SiC MOSFETs considering case temperature influence[J]. IEEE Journal of Emerging and Selected Topics in Power Electronics, 2020, 8(1): 195-205.
[29] Romano G, Fayyaz A, Riccio M, et al. A com- prehensive study of short-circuit ruggedness of Silicon carbide power MOSFETs[J]. IEEE Journal of Emerging & Selected Topics in Power Electronics, 2016, 4(3): 978-987.
[30] Zhou Yuming, Liu Hangzhi, Mu Shilu, et al. Short-circuit failure model of SiC MOSFET including the interface trapped charges[J]. IEEE Journal of Emerging and Selected Topics in Power Electronics, 2020, 8(1): 90-98.
[31] Eni E P, Szymon B, Munk N S, et al. Short-circuit degradation of 10kV 10A SiC MOSFET[J]. IEEE Transactions on Power Electronics, 2017, 32(12): 9342-9354.
[32] Ji S, Laitinen M, Huang X, et al. Short-circuit characterization and protection of 10kV SiC MOSFET[J]. IEEE Transactions on Power Electronics, 2019, 34(2): 1755-1764.
[33] 魏昌俊. SiC MOSFET短路特性研究[D]. 北京: 华北电力大学, 2019.
[34] Wang Jun, Jiang Xi. Review and analysis of SiC MOSFETs' ruggedness and reliability[J]. IET Power Electronics, 2020, 13(3): 445-455.
[35] 杨媛, 文阳, 李国玉. 大功率IGBT模块及驱动电路综述[J]. 高电压技术, 2018, 44(10): 3207-3220.
Yang Yuan, Wen Yang, Li Guoyu. Review on high- power IGBT module and drive circuit[J]. High Voltage Engineering, 2018, 44(10): 3207-3220.
[36] 张经纬, 张甜, 冯源, 等. SiC MOSFET串联短路动态特性[J]. 电工技术学报, 2021, 36(12): 2446-2458.
Zhang Jingwei, Zhang Tian, Feng Yuan, et al. Dynamic characterization assessment on series short- circuit of SiC MOSFET[J]. Proceedings of the CSEE, 2021, 36(12): 2446-2458.
[37] 庄桂元, 张兴, 刘威, 等. 带飞跨电容的三电平拓扑中SiC MOSFET过电压与过电流保护[J]. 电工技术学报, 2021, 36(2): 341-351.
Zhuang Guiyuan, Zhang Xing, Liu Wei, et al. Over- voltage and overcurrent protection of SiC MOSFET in three-level topology with flying capacitor[J]. Pro- ceedings of the CSEE, 2021, 36(2): 341-351.
[38] 康建龙, 辛振, 陈建良, 等. SiC MOSFET短路失效与退化机理研究综述及展望[J]. 中国电机工程学报, 2021, 41(3): 1069-1084.
Kang Jianlong, Xin Zhen, Chen Jianliang, et al. Review and prospect of short-circuit failure and degradation mechanism of SiC MOSFET[J]. Pro- ceedings of the CSEE, 2021, 41(3): 1069-1084.
[39] Reigosa P D, Iannuzzo F, Luo H, et al. A short-circuit safe operation area identification criterion for SiC MOSFET power modules[J]. IEEE Transactions on Industry Applications, 2017, 53(3): 2880-2887.
[40] Ji Shiqi, Laitinen M, Huang Xinghuan, et al. Short-circuit characterization and protection of 10kV SiC MOSFET[J]. IEEE Transactions on Power Electronics, 2019, 31(2): 1755-1764.
[41] Wei Jiaxing, Liu Siyang, Yang Lanlan, et al. Comprehensive analysis of electrical parameters degradations for SiC power MOSFETs under repetitive short-circuit stress[J]. IEEE Transactions on Electron Devices, 2018, 65(12): 5440-5447.
[42] Baba S, Gieraltowski A, Jasinski M T, et al. Active power cycling test bench for SiC power MOSFETs- principles, design and implementation[J]. IEEE Transa- ctions on Power Electronics, 2020, 36(2): 2661-2675.
[43] 杨媛, 文阳. 大功率IGBT驱动与保护技术[M], 北京: 科学出版社, 2018.
[44] Maerz A, Bertelshofer T, HORFF R, et al. Require- ments of short-circuit detection methods and turn-off for wide band gap semiconductors[C]//CIPS 2016: 9th International Conference on Integrated Power Elec- tronics Systems, Nuremberg, Germany, 2016: 1-6.
[45] Wang Zhiqiang, Shi Xiaojie, Xue Yang, et al. Design and performance evaluation of overcurrent protection schemes for Silicon carbide (SiC) power MOSFETs[C]// 2013 IEEE Energy Conversion Congress and Expo- sition, Denver, 2013: 5418-5425.
[46] Sun Keyao, Wang Jun, Burgos R, et al. Design, analysis, and discussion of short circuit and overload gate-driver dual-protection scheme for 1.2kV, 400A SiC MOSFET modules[J]. IEEE Transactions on Power Electronics, 2019, 35(3): 3045-3068.
[47] Xue Ju, Xin Zhen, Wang Huai, et al. An improved di/dt-RCD detection for short-circuit protection of SiC MOSFET[J]. IEEE Transactions on Power Electronics, 2020, 36(1): 12-17.
[48] Wang Jun, Shen Zhiyu, Dimarno C, et al. Gate driver design for 1.7kV SiC MOSFET module with rogowski current sensor for short-circuit protection[C]//2016 IEEE Applied Power Electronics Conference and Exposition (APEC), Long Beach, 2016: 516-523.
[49] Wang Jun, Shen Zhiyu, Burgos R, et al. Integrated switch current sensor for short-circuit protection and current control of 1.7kV SiC MOSFET modules[C]// 2016 IEEE Energy Conversion Congress and Expo- sition (ECCE), Milwaukee, 2017: 1-7.
[50] Wang Jun, Mocevic S, Burgos R, et al. High- scalability enhanced gate drivers for SiC MOSFET modules with transient immunity beyond 100V/ns[J]. IEEE Transactions on Power Electronics, 2020, 35(10): 10180-10199.
[51] Fink K, Volke A, Wei W, et al. Gate-driver with full protection for SiC-MOSFET modules[C]//PCIM Asia 2016, International Exhibition and Conference for Power Electronics, Intelligent Motion, Renewable Energy and Energy Management, Shanghai, 2016: 516-523.
[53] 卢其威, 高志宣, 滕尚甫, 等. 基于MOSFET的限流式固态断路器及其过电压抑制[J]. 电工技术学报, 2017, 32(24): 42-52.
Lu Qiwei, Gao Zhixuan, Teng Shangfu, et al. Current limiting solid state circuit breaker based on MOSEFT and its over voltage suppression[J]. Transactions of China Electrotechnical Society, 2017, 32(24): 42-52.
[54] Mainali K, Wang R, Sabate J, et al. Current sharing and overvoltage issues of paralleled SiC MOSFET modules[C]//2019 IEEE Energy Conversion Congress and Exposition (ECCE), Baltimore, 2019: 2413-2418.
[55] Kumar A, Parashar S, Sabri S, et al. Ruggedness of 6.5kV, 30A SiC MOSFETs in extreme transient conditions[C]//2018 IEEE 30th International Sympo- sium on Power Semiconductor Devices and ICs (ISPSD), Chicago, 2018: 423-426.
[56] Liao Xinglin, Li Hui, Yao Ran, et al. Voltage overshoot suppression for SiC MOSFET-based DC solid-state circuit breaker[J]. IEEE Transactions on Components, Packaging and Manufacturing Tech- nology, 2019, 9(4): 649-660.
[57] 宁红英, 孙旭霞, 杨媛. 一种基于dic/dt反馈控制的大功率IGBT驱动保护方法[J]. 电工技术学报, 2015, 30(5): 33-41.
Ning Hongying, Sun Xuxia, Yang Yuan. A high- power IGBT drive protection method based on dic/dt feedback control[J]. Transactions of China Electro- technical Society, 2015, 30(5): 33-41.
[58] 方跃财. SiC MOSFET特性研究: 驱动、短路与保护[D]. 杭州: 浙江大学, 2018.
[59] 刘扬. SiC MOSFET短路特性及保护电路研究[D]. 西安: 西安理工大学, 2020.
[60] 黄先进, 蒋晓春, 叶斌, 等. 智能化IGBT驱动电路研究[J]. 电工技术学报, 2005, 20(4): 89-93.
Huang Xianjin, Jiang Xiaochun, Ye Bin, et al. Research on intelligent IGBT drive circuit[J]. Transa- ctions of China Electrotechnical Society, 2005, 20(4): 89-93.
[61] 杨冬平, 王莉, 江登宇, 等. 降栅压技术在MOSFET驱动中的应用[J]. 电力系统及其自动化学报, 2010, 22(1): 1-4, 53.
Yang Dongping, Wang Li, Jiang Dengyu, et al. Application of drop gate voltage technology in MOSFET drive circuit[J]. Proceedings of the CUS- EPSA, 2010, 22(1): 1-4, 53.
Review on Short-Circuit Protection Technology of SiC MOSFET
Abstract With the development of power electronics technology, SiC MOSFETs show significant advantages in power electronics applications of high frequency, high voltage and high temperature due to its excellent material properties. However, the high switching speed and poor short-circuit withstand capability of SiC MOSFETs bring new challenges to short-circuit protection technology. In this paper, different short-circuit fault types and testing methods of SiC MOSFETs are introduced firstly. Secondly, the short-circuit failure mode and mechanism of SiC MOSFET are analyzed. On this basis, the principle, advantages and disadvantages of the existing short-circuit detection and turn-off technology of SiC MOSFETs are summarized in detail, and the problems and challenges in the application of the current short-circuit protection technology of SiC MOSFETs are discussed. Finally, the development trend of SiC MOSFET short-circuit protection technology is prospected.
keywords:SiC MOSFET, short-circuit test, short-circuit failure, short-circuit protection
DOI: 10.19595/j.cnki.1000-6753.tces.211119
中图分类号:TM46
文 阳 男,1990年生,博士,讲师,研究方向为宽禁带半导体器件驱动保护技术、状态感知与监测、失效分析及寿命预测。E-mail: wenyang@xaut.edu.cn
杨 媛 女,1974年生,教授,博士生导师,研究方向为电路与系统设计、宽禁带半导体器件应用等。E-mail: yangyuan@xaut.edu.cn(通信作者)
收稿日期 2021-07-21
改稿日期 2021-08-11
国家自然基金项目(62174134)、陕西省教育厅专项科学研究计划项目(21JK0791)和陕西省创新能力支撑计划项目(2021TD-25)资助。
(编辑 陈 诚)